Разработка ученых Института физики полупроводников им А.В. Ржанова СО РАН (ИФП СО РАН) — апробированные кремниевые меры высоты и плоскостности — востребована среди производителей высокоточной измерительной аппаратуры (в частности, атомно-силовых микроскопов), на предприятиях микро- и наноэлектроники, высокоточного машиностроения.
На сегодняшний день в России и мире — это единственный вид мер, охватывающий диапазон от сотых долей нанометра до десятков нанометров. Обычно для измерения объектов, размером в доли нанометра и десятки нанометров, используются разные масштабные «линейки», что приводит к увеличению количества искажений и ошибок. Подробности работы опубликованы в журнале Американского химического общества «ACS Applied Materials & Interfaces».
«Отличие наших мер от тех, что широко используются сейчас — это прослеживаемость: мы можем одновременно измерить объекты, размеры которых доли нанометра и десятки нанометров. Наши меры перекрывают весь диапазон от 0,3 до 100 нм. Сейчас для измерения объектов в сотни нанометров используется одна “линейка”, а для единиц нанометров — другая. Это приводит к определённым сложностям: проводится компарирование (сличение) линеек, определяется масштаб неизбежно возникающих ошибок», — говорит заместитель директора по развитию ИФП СО РАН, первый автор статьи в «ACS Applied Materials & Interfaces» кандидат физико-математических наук Дмитрий Владимирович Щеглов.
Мера плоскостности представляет собой идеально гладкую поверхность кристалла кремния, диаметром до миллиметра, а мера высоты — «стопка» атомных слоев кремния, может варьировать от одного до нескольких сотен слоев. Высота одного атомного слоя — 0,31356 нанометров. Такие масштабы сложно представить — это примерно в двести тысяч раз тоньше человеческого волоса.
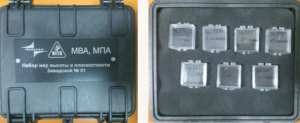

Фото: комплекты мер
С помощью новых мер можно проводить измерения объектов, размеры которых сопоставимы с атомными и даже меньше их — постоянно уменьшающихся элементов электронно-компонентой базы или квантовых наносистем, фрагментов молекул ДНК, структурных особенностей углеродных нанотрубок или каталитических наночастиц. Меры могут использоваться для усовершенствования и калибровки измерительного оборудования — оптических и атомно-силовых микроскопов, развития физических основ новой электроники.
«Для этих мер сотрудники Всероссийского научно-исследовательского института оптико-физических измерений (ВНИИОФИ) разработали паспорт и руководство по эксплуатации. Также были проведены экспериментальные исследования, показавшие, что меры соответствуют заявленным метрологическим характеристикам. Ранее, другой организацией, меры высоты были включены в Федеральный информационный фонд (ФИФ). Включение средства измерения в ФИФ позволяет использовать его в сферах государственного регулирования, а дополнительно — в качестве эталона определенного ранга в поверочной схеме, если он по своим характеристикам ему соответствует. За разработкой поверочной схемы нужно обращаться во Всероссийский научно-исследовательский институт метрологии им. Д. И. Менделеева, где хранится первичный эталон метра», — объясняет начальник отделения ВНИИОФИ доктор технических наук Владимир Леонидович Минаев.
Кто может использовать меры?
«В наших мерах заинтересованы производители атомно-силовых, оптических микроскопов, кроме того, мы сами ведем разработку специальных микроскопов нового типа, в рамках гранта Российского научного фонда № 19-72-30023. Меры могут применяться в оптических схемах, в том числе схемах квантовой передачи информации, использоваться там, где требуется высокоточная синхронизация систем на Земле и в космосе, как в GPS, GLONASS. Другой вариант — меры нужны в научных экспериментах: атомно-гладкие поверхности мы передавали в Институт химической биологии и фундаментальной медицины СО РАН, ФИЦ “Институт катализа им. Г.К. Борескова”, как подложки для исследований. Такая поверхность может выступать одновременно и подложкой, и “линейкой” — и в этом тоже ее преимущество», — комментирует Д. Щеглов.
Владимир Минаев добавляет, что ему неизвестны другие комплексы мер, охватывающие диапазон от десятых долей нанометра до сотен нанометров: «Существуют меры компании VLSI (США) от 10 нанометров и более. Но менее 1 нм, я не встречал. В своей работе я рекомендую меры, созданные специалистами ИФП СО РАН, разработчикам и пользователям атомно-силовых, растровых электронных и интерференционных микроскопов, для которых важен субнанометровый диапазон, так как мер в этом диапазоне нет. Пока этот диапазон не очень востребован, насколько мне известно. Единственные, кто делает измерения в нем — изготовители лазерных зеркал. Для них очень важно получить шероховатость в ангстремном диапазоне (десятые доли нанометров).На текущий момент их приборы калибруются мерами высоты, имеющими размер десятки нанометров, думаю, что рано или поздно потребуются меры на меньший диапазон».
Сейчас атомно-гладкое зеркало, созданное в ИФП СО РАН, уже используется в уникальном приборе: интерференционном микроскопе, который разработан совместно специалистами ИФП СО РАН и Конструкторско-технологического института научного приборостроения СО РАН. Микроскоп позволяет вести быструю неразрушающую диагностику особенностей рельефа поверхности нанообъектов: регистрирует перепады высот порядка десятой доли нанометра. Обычно для подобных задач, решаемых при создании новых материалов, исследовательских процессах, промышленной диагностике, используется атомно-силовой микроскоп. Но, во-первых, игла атомно-силового микроскопа воздействует на поверхность, изменяя ее, во-вторых, сканирование на атомно-силовом микроскопе длится в несколько раз дольше, чем исследование с помощью оптического прибора.
Во многом разработка — комплекс мер — опережает существующие технологии (не везде нужна такая точность измерений), и находится в начале индустриального применения. Ученые считают, что на данном этапе оптимально было бы создать прибор, который позволит использовать потенциал разработки по максимуму, что в итоге даст хороший эффект по отношению к существующим индустриям ― микроэлектронной отрасли, отрасли научного приборостроения, высокоточного приборостроения. «Если это (создание такого прибора) получится, то необходимо будет передавать для внедрения уже готовый прибор, в основе которого лежат меры, а не сами меры отдельно», ― отмечает Дмитрий Щеглов.

Фото: мера высотой 26,025 нанометра. Изображение получено с помощью атомно-силового микроскопа. Резкая макроступень внизу изображения состоит из 83 моноатомных ступеней высотой 0,31356 нм, которые подсчитываются на разреженном участке вверху изображения (штриховой прямоугольник, его увеличенный фрагмент приведён справа).
ИФП СО РАН





Нет комментариев